Figures & data
Table 1. Samples used to study segregation during gate oxidation.
Figure 3. Id-Vg profiles of SA3 (NO annealed gate dielectric) sample for LVN and LVP transistor. Length dependency is shown well fitted due to the calibration of process simulation parameters.
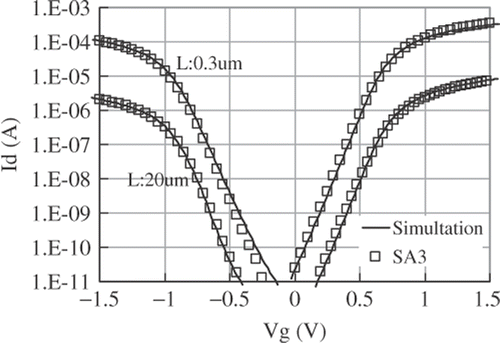
Figure 5. Id-Vg profiles for LVN and LVP transistor. SA4 sample (plasma nitrided gate dielectric) possesses 0.1 V lower VTH value than SA3 sample.
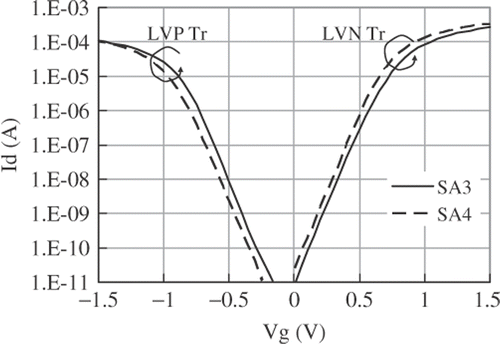
Figure 6. C-V profiles of surface channel NMOS and buried channel PMOS capacitors with different gate oxidation conditions. Buried channel PMOS capacitor of SA4 exhibits uncommon shape near Vg = 0 V.